https://xtech.nikkei.com/atcl/nxt/column/18/02277/030600012/
https://xtech.nikkei.com/atcl/nxt/column/18/02277/030600012/
窒化ガリウム(GaN)ベースの縦型パワーデバイスの開発が、社会実装に向けて着実に前進している。現時点ではシリコンカーバイド(SiC)ベースのパワーデバイスの応用が想定されている、電気自動車(EV)のトラクションインバーター(主モーターの駆動回路)などの高耐圧・大電流の応用に適用可能なデバイスである。
環境省事業「革新的な省CO2 実現のための部材や素材の社会実装・普及展開加速化事業」の枠組みの中で、EV用インバーターへの適用を想定した縦型GaNパワーデバイスをそれぞれ開発しているパナソニックホールディングス(パナソニックHD)と豊田合成に開発の進捗状況を聞いた。
GaNの物性を同様のワイドバンドギャップ材料であるSiCと比較すると、パワーデバイス用材料としての適性はSiCよりもGaNの方が高いことが明確になっている。しかし、現時点でのGaNデバイスは、例えば自動車分野では車載充電器(OBC)やDC-DCコンバーターなどにGaN on Siベースの横型HEMT構造のパワーデバイスを利用する構想はあるものの、インバーターに適用した商用車を市場投入する計画はいまだ見られない。
EVなど電動車のインバーター回路は少なくとも400Vクラスの高電圧で駆動する。ところが、現時点で量産されているGaNデバイスには、こうした高電圧のパワーエレクトロニクス回路で使用するパワーデバイスに対応可能な1000V以上の耐圧と大電流を流せる製品がない。その実現には、現行のシリコン(Si)ベースのIGBTやSiCベースのMOSFETと同様の構造である、GaN基板の厚さ方向に電流を流して高耐圧・大出力に対応できる縦型GaNデバイスの作製が必須になる。
縦型GaNデバイスとして、JFETとMOSFETを同時並行開発
パナソニックHDと豊田合成は、環境省事業の枠組みの中で、EV用インバーターへの適用を想定した2種類の縦型GaNパワーデバイスをそれぞれ開発している。1つは、パナソニックHDが開発する高周波動作による応用機器の小型・軽量化が期待できるp-GaNゲート構造の縦型ジャンクションFET(JFET)。もう1つは、豊田合成が開発する高い汎用性が期待できる縦型トレンチMOSFETである。
2種類のデバイスは、既に、耐圧650V、電流20Aクラスの動作をしており、今後、大阪大学とパナソニックHD、豊田合成が共同開発しているオン抵抗をSiC基板よりも1ケタ低減することが可能な「OVPE 法(Oxide Vapor Phase Epitaxy:酸化物気相成長法)」と呼ぶGaN基板の利用を想定している。
名古屋大学がこれらの試作品を活用し、それぞれの静特性と動特性を考慮して、回路構成や動作条件、機構の仕様を最適化した出力50kWのインバーターを開発中で、2025年には走行可能なEVを完成させる予定である。今後は、さらなる高出力化を目指して、それぞれのデバイス構造で耐圧1200Vを実現するデバイスも開発する計画だ。
高速動作可能な縦型JFET、650V耐圧品が実現し次は1200V耐圧品に挑戦
パナソニックHDが開発しているp-GaNゲート構造の縦型JFETでは、ゲート周辺部をp-GaN/AlGaN/GaN構造とすることにより、ノーマリオフと低オン抵抗を可能にしている(図1)。電流が流れる経路の一部にHEMTのチャネルと同様の2次元電子ガス(2DEG)が形成される。このため、オン抵抗を低減しやすく、高速動作にも向く。スイッチング周波数の高い電源回路やモーター駆動回路に適用することで、電力効率を高めながらコイルなど回路を構成する部品の小型化を実現することが可能になる。
また、ゲート部のp-GaNを利用して電流ブロック層端部にかかる電界を緩和し、リーク電流を低減する工夫もしている。試作したデバイスのうち、10A仕様のデバイスでは、しきい値電圧1.5V、RonA=1.7mΩcm2、破壊耐圧 600V 以上の特性が得られることを実証した。
GaNデバイスは、SiやSiCのようには熱酸化によって高品質な半導体と絶縁膜の界面を形成することができないため、MOSFET構造の形成が困難である。この点が、GaNデバイスの製造プロセスを確立する上での障壁の1つとなっている。ただし、パナソニックHDが開発しているデバイスは、「JFET構造であるため、酸化膜を形成する必要がない。
現在、PC向け超小型ACアダプターなどに搭載されるようになった横型HEMT構造のGaNパワーデバイスも同様のプロセスで製造されており、既存のGaNデバイス用工場での製造がしやすい。また、ゲートを電圧で駆動するMOSFETとは異なり、JFETは電流駆動となる。ドライバーICなど周辺回路の構成がSiやSiCとは変わってくるが、この点に関しても、横型デバイス向けの利用技術の蓄積が生きる」(パナソニックHD)としている。
パナソニックHDは、社会実装を見据えて、開発したデバイスの信頼性と熱抵抗も評価。短絡耐量試験と連続スイッチング試験を実施し、試作したデバイスをさらに改善するための課題を抽出した。OVPE法で形成したGaN層は、低抵抗化できるため発熱が減るが、その一方で熱抵抗が高く放熱しにくいという問題を抱える。OVPE法を適用するメリットを引き出すためには、デバイスの動作に悪影響を及ぼさないようなデバイス設計やパッケージの放熱手段の開発を検討する必要が出てくる。
同社では、耐圧1200V以上の縦型GaNデバイスの開発にも着手し、ドリフト層に意図せず取り込まれてドナーを補償する炭素(C)の濃度を低減できる結晶成長条件を検討しており、C濃度を5×1015/cm3以下に抑制できるドリフト層の成長条件を見出し、縦型GaNデバイス作製を進めている。しかし、今後高耐圧縦型GaNデバイスを安定的に作製するためには、C濃度をさらに低減する結晶成長技術が必要としている。
また、社会実装を見据えて、開発したデバイスの信頼性試験および熱抵抗評価も行っている。OVPE法で作製したGaN基板は、低抵抗化できるため発熱が減るが、その一方で熱抵抗が高く放熱しにくいという問題を抱える。OVPE法を適用するメリットを引き出すためには、デバイスの動作・信頼性に悪影響を及ぼさないようなデバイス設計やパッケージの放熱手段の開発をする必要がある。
高い汎用性が期待できる縦型MOSFET、既にSiCに匹敵する性能の試作品が完成
豊田合成が開発しているトレンチMOSFETは、基本的には、SiやSiCをベースにした縦型トレンチMOSFETと同じ構造を採用している(図2)。同社のプロセスでは、GaN基板上にドリフト層(n-GaN層)、ボディ層(pGaN層)、ソースコンタクト層(n+GaN層)をエピタキシャル成長で一括形成する。同社の方法では、pGaN層をイオン注入で作っていないため、製造は比較的容易だ。
その後、コンタクト領域のリセス、ゲートトレンチをドライエッチングで加工。トレンチゲート構造に形成するゲート絶縁膜は、膜厚と膜質を均一にするため、原子層体積法を利用して形成している。同社のMOSFETでは、1チップに六角形のMOSFETセルを数十万個並列に敷き詰めた構造を取り、大電流化を実現する際にはセル数を増やすことで対応する。
MOSFETは、JFETよりも信頼性の確保に欠かせないノーマリオフ動作を実現しやすい点が特徴である。また、より微細な加工技術を適用することで、高性能化しやすい点もメリットとなる。自動車のように、従来のデバイスとの互換性が重要視される用途では、高性能化を追求する以前に実績のあるデバイス構造の採用や、回路構成などの利用技術において現時点との差異が少ないことが求められる傾向がある。MOSFETは、こうした要求に応える。
先述したように、豊田合成は、既に650V、20Aで基本的な特性を評価できるレベルの試作品は完成させている。そして、「OVPE法を用いて作製した超低抵抗GaN基板を使わなくても、SiCデバイスに匹敵する縦型GaN MOSFET実現の手ごたえは得られている。今後は、OVPE法を適用することで、さらなる性能向上を狙う」(豊田合成)とする。環境省事業では、2025年の50kW級インバーターの実現を目指しているが、650V耐圧のデバイスの定格電流を60Aに上げて対応していく方向である。その後、出力を100kWにまで高める場合には、1200V耐圧のデバイスが必要になるとみている。
研究レベルでは着実に成果を上げているが、量産に向けて、まだまだ解決すべき課題が残されているようだ。豊田合成によると、基板の平坦度(SFQR:Site Front least sQuare Range)とプロセスの歩留まりには相関があるという。今回は、SFQR の良い基板を選んで用いることで、素子面積の大きい大電流対応のデバイスが試作可能になり、その結果650V耐圧、電流20Aの縦型トレンチMOSFETを実現できたという。本プロジェクトでは、このような素子開発の実験結果を基板開発に直ちにフィードバックすることで、基板から素子の開発を一気に加速できることも強みの一つである。
また、完成した試作品を評価した名古屋大学からは、スイッチング動作時にオン抵抗が大幅に増加してしまうという課題がフィードバックされた。豊田合成が調査した結果、pGaN中のマグネシウム(Mg)濃度と指摘された現象の発生に相関があり、電流負荷が高い条件で顕在化することが確認された。ノーマリオフ動作を維持するためにMg濃度の調整範囲をあまり広く取れないことがネックとなる懸念があるため、今後は別のアプローチを検討していくとしている。
1200V以上の耐圧の実現に向けたアプローチでは、パナソニックHDのJFETと同様に、ドリフト層の不純物濃度制御が焦点になるようだ。
縦型GaNの進歩と同時に、高耐圧化した横型GaNの商品化検討へ
SiCデバイスに対抗できる縦型GaNデバイスの開発が着実に進んでいる一方で、横型GaN FETをさらに高耐圧な条件で利用可能にするための技術開発も行われている。豊田合成は、HEMT構造をベースとして、チャネル領域にGaN/AlGaN/GaNというヘテロ接合を形成した「分極超接合(Polarization Super Junction:PSJ)構造」と呼ぶ技術を検討している。PSJ構造により、SiC MOSFETやSi IGBTで対応するような1万Vを超える超高耐圧の実現が期待できる。
PSJ構造のGaN FETは、HEMT構造に比べるとスイッチング周波数は低くなるが、それでも数MHzの動作は可能であり、SiCデバイスと同等以上の耐圧を実現しながら、スイッチング周波数をSiC MOSFET(上限は数百kHz)やSi IGBT(数十kHz)より大幅に高めることができる。横型デバイスであるためGaN自立基板より安価で絶縁性に優れるサファイア基板(GaN on サファイア)を使えば、縦型GaNよりも早期の市場投入が狙える点も利点である。
もちろん、将来的に縦型GaN用に開発される低抵抗・高品質GaN自立基板の技術が絶縁性基板として利用できるようになれば、高耐圧・高性能なGaN on GaNのPSJ素子でさらなる市場拡大が期待できる。豊田合成は「PSJ構造のエピやプロセス技術の開発が進んだことで、GaN on サファイアでも当初予想していたより高い性能、信頼性が得られる可能性も見えてきた。GaN自立基板と縦型GaNの開発を着実に進めながら、GaN on サファイアによるPSJ素子の商品性、事業性を検証し、GaNパワーデバイス市場への早期参入が可能か見極めたい」としている。
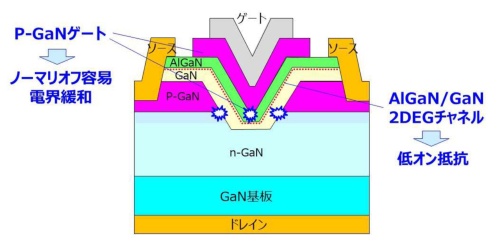
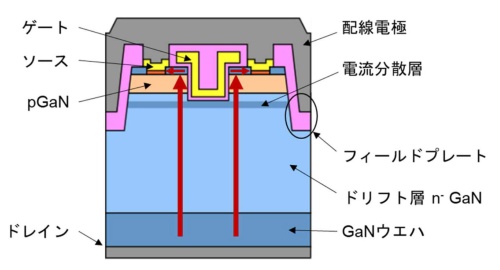








0 コメント:
コメントを投稿