https://xtech.nikkei.com/atcl/nxt/column/18/02748/030800004/
https://xtech.nikkei.com/atcl/nxt/column/18/02748/030800004/
半導体デバイス微細化のカギとなるのが、波長13.5nmの極端紫外線(EUV)を使うEUV露光装置だ。フォトリソグラフィー工程において、フォトマスクのパターンをウエハー上に照射する露光を担う。7nm世代以降のロジック半導体や最先端メモリーの製造で不可欠な同装置は、世界でオランダASMLだけが供給している*1。
*1 近年の先端半導体デバイスでは、トランジスタがプレーナ(平面)FETからFinFETやGAA(Gate All Around)と呼ばれる3次元構造になるのに伴い、半導体プロセスノードを表現する数字が、実際の加工寸法とは必ずしも一致しなくなっている。
世界では、米Intel(インテル)や韓国Samsung Electronics(サムスン電子)、台湾積体電路製造(TSMC)といった大手半導体メーカーがEUV露光装置を導入して先端半導体デバイスを量産している。一方、3社 のような先端半導体デバイスの製造拠点を持たない日本では、これまで同装置による本格的な量産はなかった*2。
*2 ASMLによると、過去に日本国内で同社のEUV露光装置を運用した実績はある。
ところが近年、風向きが変わり始めた。国内企業の支援を受けて設立された半導体企業Rapidus(ラピダス、東京・千代田) は、北海道の半導体工場にEUV露光装置を導入すると表明した。米Micron Technology(マイクロン・テクノロジー) も広島工場に、同装置を導入する見込みだ。
いよいよ国内にも本格的に導入されるEUV露光装置だが、技術的な特長はどこにあるのか。エーエスエムエル・ジャパン テクニカルマーケティングディレクターの森崎健史氏によると、同装置を構成する高精度な「ミラーレンズ」と、出力25kWの炭酸ガス(CO2)レーザーを用いた「EUV光源」の実現が、同装置を開発する上で壁だったという。
ミラーレンズでEUV光を届ける
半導体デバイスの製造に必要なフォトリソグラフィー工程は、エッチング工程の前段階に当たる工程で、大まかに[1]フォトレジスト塗布[2]露光[3]現像の3段階を経る。
まず、ウエハー上の薄膜にフォトレジストを塗布し、パターンが描かれたフォトマスクを用いて露光する。このときウエハー上に投影されるのは、フォトマスクのパターンを縮小したパターンだ。現像すると、露光したパターンに従ってフォトマスクが取り除かれ、薄膜が露出した部分が現れる。そして、その露出部分だけを後のエッチング工程で削り取るという流れだ。
一連のフォトリソグラフィー工程の中で、露光装置はその名称の通り、フォトマスクを使った露光作業を担っている。一般に、短い波長の光源を使える露光装置ほど、微細なパターンを露光できる。EUV光による露光技術は現時点で最先端とされ、前述の通り、世界ではASMLだけが同装置の量産に成功している。
同社のEUV露光装置では、光源から出力したEUV光をミラーレンズ*3で反射させながらフォトマスクに届け、フォトマスクで反射したEUV光を、さらにウエハーに届ける。露光を終えたらステージ上のウエハーを動かし、次々と同じパターンを照射していく。
*3 ミラーレンズ
鏡を使って光を集めるレンズ。
「EUV光はさまざまな物質に吸収されやすく、空気(を構成する分子)にも吸収される性質がある」(森崎氏)。そこで、前述した一連の機能は、真空チャンバー内にある。
光の反射を多用しているのも特長だ。従来の露光装置では、光源からの光がフォトマスクとレンズを通過した後、ウエハー上のフォトレジストに届く。写真機と似た仕組みだ。EUV露光装置では、EUV光源からの光をフォトマスクに当てた反射光を利用する。フォトマスクのパターンを縮小投影するのに使うレンズも、反射を利用するミラーレンズだ。反射を多用するのは、透過させるとそこでEUV光が吸収されてしまうためだ。
ミラーレンズの製造元はドイツCarl Zeiss(カール・ツァイス)の子会社。微細なパターンを投影するために、同レンズの表面加工には高い精度が必要だったという。具体的には、表面粗さ50pm以下の精度で磨かれており、例えるなら「ドイツの国土面積に対して高さのばらつきを1mm以下に抑えるようなものだ」(森崎氏)。
いよいよ国内にも本格導入される見込みのEUV露光装置だが、技術的な特長はどこにあるのか。同装置を開発するASMLによると、高精度な「ミラーレンズ」と出力25kWの炭酸ガスレーザーを用いた「EUV光源」の実現が壁だった。

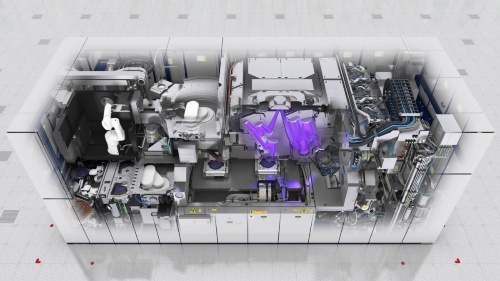
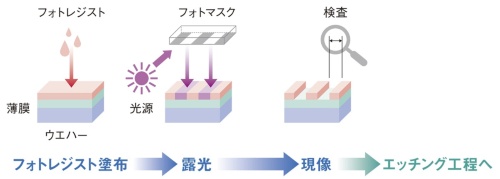









0 コメント:
コメントを投稿